 |
|
| Appunti tecniche |
|
 |
|
| Appunti tecniche |
|
| Visite: 1864 | Gradito: |
Leggi anche appunti:Traduzione in ladderTRADUZIONE IN LADDER Per tradurre in ladder il programma SFC si sono fatte I circuiti elettriciI CIRCUITI ELETTRICI Il circuito elettrico è sempre costituito Derivatore idealeDerivatore ideale Questa configurazione prende il nome di derivatore ideale, |
 |
 |
Caratterizzazione dell'Attacco Ionico in Plasma
Lo
scopo della caratterizzazione dell'attacco ionico in plasma di substrati di ![]() , mascherati da Al, è stato quello di ottenere un gradino
dello spessore di circa 20nm a pareti verticali, minimizzando il danneggiamento
della superficie attaccata.
, mascherati da Al, è stato quello di ottenere un gradino
dello spessore di circa 20nm a pareti verticali, minimizzando il danneggiamento
della superficie attaccata.
É
stato anche investigato il cambiamento della selettività dell'attacco dell'![]() rispetto all'Al:
rispetto all'Al:

al variare della pressione della camera di reazione e della potenza fornita dal generatore RF.
Sono stati condotti un totale di 23 attacchi, i cui parametri e risultati sono presentati nella Tab. I:

Tab. I
III.1 Sistema per la Litografia a Fascio di Elettroni
Per effettuare i passi di litografia a fascio di elettroni (EBL), nel laboratorio di fabbricazione di dispositivi nanoelettronici è stato adattato alla scrittura (Bibl. 6) un microscopio elettronico a scansione (SEM JEOL 6500F Field Emission Gun).
Tramite un CAD vengono definite le strutture che si vogliono realizzare, che vengono salvate in un file con formato GDSII. Questo file verrà elaborato da un sistema di creazione e generazione delle maschere che presenta un' organizzazione di tipo Master-Slave.
Sono impiegati di due PC, collegati tramite una porta di comunicazione seriale. Il master è quello con cui l'operatore interagisce tramite un'interfaccia grafica sviluppata sotto ambiente Linux.
Il master dialoga con slave che legge i dati e li trasferisce in modalità real-time, cioè controllando il fascio del microscopio con una temporizzazione ,esatta; questo viene ottenuto facendo girare lo slave sotto un sistema operativo DOS a cui sono state disabilitate le interruzioni. Lo slave presenta un bus di uscita su 24 pin con i quali pilota i convertitori digitale-analogico (D/A) a 16 bits, le schede di canale che selezionano il circuito di campiona mento (S&H) opportuno, il beam blanker e il comando di scansione esterna del SEM (external- scan).
Per schermare il sistema dai disturbi si ricorre ad una scheda di input-output che separa lo slave dalla rete di conversione D/A: questa rete (il Pattern Generator), alimentata a batterie e quindi elettricamente indipendente dal master, riceve le strutture da disegnare dallo slave e controlla il SEM nella realizzazione delle geometrie sul campione.
Ogni struttura deve essere scomposta in punti: muovendo il fascio su tutti i punti che compongono una geometria, il resist steso sul campione viene impresso e potrà quindi essere selettivamente rimosso con il successivo sviluppo (Fig. 1).

Fig. 1: Scomposizione della geometria in passi del fascio.
Il
fascio de elettroni verrà posizionato sequenzialmente su ogni singolo punto per
un certo tempo di permanenza (dwell) ![]() .
.
Il valore di ![]() e
e ![]() può essere impostato
modificando l'ingrandimento del microscopio: dopo una calibrazione durante la
fase di installazione del pattern generator, per il microscopio impiegato è
risultato:
può essere impostato
modificando l'ingrandimento del microscopio: dopo una calibrazione durante la
fase di installazione del pattern generator, per il microscopio impiegato è
risultato:
![]()
per un
ingrandimento M=40X. Essi mostrano inoltre una dipendenza lineare con M: ad
esempio, per un ingrandimento di 400X valgono ![]() e
e ![]() .
.
I
parametri ![]() ,
, ![]() ,
, ![]() , con la corrente del fascio I, determinano la dose di
esposizione D, misurata in carica per unità di superficie: C/m2.
Quantificare la dose è molto complesso, dal momento che dipende dalle
dimensioni del fascio e dalla distribuzione degli elettroni incidenti e
riflessi: una stima veloce ed approssimata, tanto più valida, quanto più le
strutture sono grandi rispetto alla sezione del fascio può essere effettuata
da:
, con la corrente del fascio I, determinano la dose di
esposizione D, misurata in carica per unità di superficie: C/m2.
Quantificare la dose è molto complesso, dal momento che dipende dalle
dimensioni del fascio e dalla distribuzione degli elettroni incidenti e
riflessi: una stima veloce ed approssimata, tanto più valida, quanto più le
strutture sono grandi rispetto alla sezione del fascio può essere effettuata
da:
![]()
La conoscenza del valore di ![]() e
e ![]() permette anche di
valutare le massime dimensioni dell'area di scrittura. Nel sistema sviluppato
sono impiegati convertitori D/A da 16 bits, quindi il numero di passi in x ed y
è limitato a
permette anche di
valutare le massime dimensioni dell'area di scrittura. Nel sistema sviluppato
sono impiegati convertitori D/A da 16 bits, quindi il numero di passi in x ed y
è limitato a ![]() : per la scrittura delle geometrie, si ha dunque a
disposizione un reticolo di
: per la scrittura delle geometrie, si ha dunque a
disposizione un reticolo di ![]() punti.
punti.
Le dimensioni dell'area di scrittura dipendono dall'ingrandimento impostato: per M=400X, l'area di scrittura è di:
![]()
Se si imposta M=40X, l'area di scrittura aumenta di un fattore cento, ma aumenta la minima dimensione ottenibile per le nostre geometrie.
La scelta dell'ingrandimento deriva quindi da un compromesso tra le dimensioni dell'area di scrittura e la minima dimensione ottenibile per le geometrie.
Il
resist usato per l'EBL è il PoliMetilMetAcrilato (PMMA: ![]() ), un resist negativo organico. Il PMMA viene venduto in
forma polverizzata, e per essere utilizzato deve essere sciolto in un solvente,
l'anisolo (
), un resist negativo organico. Il PMMA viene venduto in
forma polverizzata, e per essere utilizzato deve essere sciolto in un solvente,
l'anisolo (![]() ): la sensibilità del resist agli elettroni dipende dal peso
molecolare medio del PMMA e dalla concentrazione di PMMA in anisolo.
): la sensibilità del resist agli elettroni dipende dal peso
molecolare medio del PMMA e dalla concentrazione di PMMA in anisolo.
Il resist viene steso sul campione mediante un processo di SPINNING (centrifugazione), che consiste nella deposizione del materiale sopra il campione, che viene poi fatto girare per mezzo di uno spinner: il tempo di spinning e la velocità di rotazione (espressa in giri al minuto: rpm) determinano lo spessore dello strato di resist sul campione. Il passo di deposizione termina con la COTTURA del campione su un hot plate a 200°C per un'ora.
Dopo
l'esposizione viene effettuato lo SVILUPPO,
in soluzioni di isopropanolo e MIBK (4-metil 2-pentanone isobuitl
metilchetone: ![]() ) a temperatura ambiente senza controllo della temperatura.
Il tempo di sviluppo e la composizione della soluzione dipendono dal tipo di
resist da sviluppare.
) a temperatura ambiente senza controllo della temperatura.
Il tempo di sviluppo e la composizione della soluzione dipendono dal tipo di
resist da sviluppare.
Nel laboratorio di fabbricazione di dispositivi nanoelettronici sono stati messi a punto tre processi litografici, che permettano di raggiungere risoluzioni diverse: il processo per bassa risoluzione (PLR), quello per alta risoluzione (PHR), e quello per ultra alta risoluzione(PUHR).
Processo Bassa Risoluzione (PLR)
Sul campione vengono stesi due strati di resist.
Il primo è di resist PMMA di peso molecolare medio 350000 al 6% in peso in anisolo, che viene steso in questo modo:
SPINNING: 1 minuto a 5000 rpm.
COTTURA: 1 ora a 200°C
Raffreddamento per 5'.
Il secondo strato è di resist PMMA di peso molecolare medio 996000 al 6% in peso in anisolo, che viene steso in questo modo:
SPINNING: 1 minuto a 5000 rpm.
COTTURA: 1 ora a 200°C
Raffreddamento per 5'.
SVILUPPO: 1 minuto in una soluzione 1:1 in volume di IPA e MIBK.
Processo Alta Risoluzione (PHR)
Sul campione vengono stesi due strati di resist.
Il primo è di resist PMMA di peso molecolare medio 350000 al 3% in peso in anisolo, che viene steso in questo modo:
SPINNING: 30 secondi a 4000 rpm.
COTTURA: 1 ora a 200°C
Raffreddamento per 5'.
Il secondo strato è di resist PMMA di peso molecolare medio 996000 al 3% in peso in anisolo, che viene steso in questo modo:
SPINNING: 30 secondi a 4000 rpm.
COTTURA: 1 ora a 200°C
Raffreddamento per 5'.
SVILUPPO: 30 secondi in una soluzione 3:1 in volume di IPA e MIBK.
Processo Ultra Alta Risoluzione (PUHR)
Sul campione vengono stesi due strati di resist.
Il primo è di resist PMMA di peso molecolare medio 350000 al 1.5% in peso in anisolo, che viene steso in questo modo:
SPINNING: 30 secondi a 6000 rpm.
COTTURA: 1 ora a 200°C
Raffreddamento per 5'.
Il secondo strato è di resist PMMA di peso molecolare medio 996000 al 1.5% in peso in anisolo, che viene steso in questo modo:
SPINNING: 30 secondi a 6000 rpm.
COTTURA: 1 ora a 200°C
Raffreddamento per 5'.
SVILUPPO: 30 secondi in una soluzione 3:1 in volume di IPA e MIBK.
III.2 Passi di Processo
Negli
esperimenti sono stati impiegati wafer di Si Czochralski di tipo n con
orientazione ![]() , spessore 500-560
, spessore 500-560![]() e resistività 0.5-1
e resistività 0.5-1![]() .
.
III.2.1 Preparazione dei campioni
Il wafer è innanzitutto pulito con il LAVAGGIO IN ULTRASUONI: esso viene lavato
nel bagno a ultrasuoni, dopodiché viene tenuto 5' sull' hot plate a 200°C.
Il wafer viene poi sottoposto ad OSSIDAZIONE TERMICA DRY o WET.
Dopo l'ossidazione, il wafer deve essere tagliato per ricavarne campioni di dimensioni opportune.
III.2.2 Litografia a Fascio di Elettroni
Su tutti i campioni è stato steso il BILAYER 3%, su cui è stata effettuata la scrittura a ingrandimento 40X.
Le geometrie scritte consistono in gruppi di rettangoli con un lato molto maggiore dell'altro, come mostrato in Fig. 1.

Fig. 1: Rappresentazione schematica della vista dall'alto di un
campione dopo il passo di litografia: le aree rettangolari più scure sono
quelle in cui il resist è stato impresso e sviluppato, lasciando scoperto l'![]()
Dal momento che la sensibilità del resist al bombardamento di elettroni dipende dal peso molecolare medio del PMMA, diminuendo all'aumentare di questo: il primo strato steso sul campione, di peso molecolare 350000, è quindi più sensibile del secondo, di peso molecolare 996000. Di conseguenza, con lo sviluppo verrà definita nello strato superiore un'area minore che nello strato inferiore (Fig. 2).
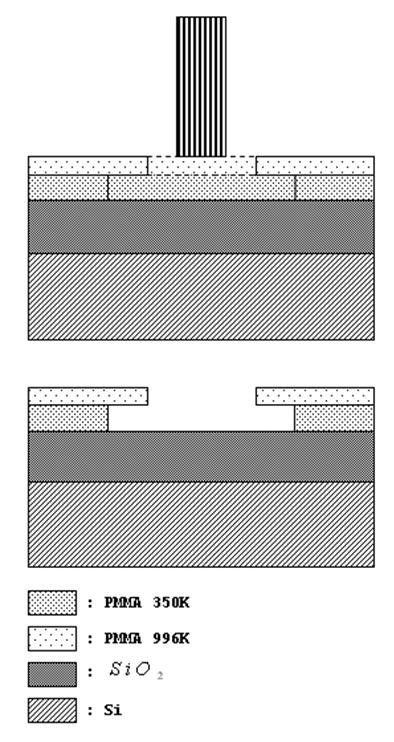
Fig. 2: Rappresentazione della sezione trasversa del bilayer di resist dopo lo sviluppo.
III.2.3 Evaporazione e Lift-off
Il campione subisce
a questo punto il passo di evaporazione termica dell'Al. Su tutti i campioni
sono stati evaporati 20nm di Al ad un velocità di deposizione di ![]() .
.
Il passo successivo è il lift-off dell'alluminio evaporato: il campione viene immerso in acetone alla temperatura di 45°C, cosicché questo dissolva il resist al di sotto del metallo depositato cominciando dalle pareti (Fig. 3).
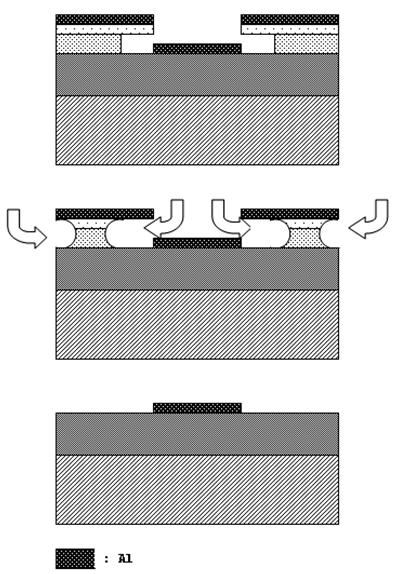
Fig. 3: Rappresentazione schematica del processo di lift-off.
Perché l'acetone possa penetrare al di sotto dello strato di metallo da asportare è importante che ci sia una discontinuità nell'alluminio depositato: il particolare profilo ottenuto con il bilayer di resist serve proprio a creare questa discontinuità (Fig. 2).
Esiste quindi un limite superiore allo spessore di Al evaporato, oltre il quale il lift-off non ha successo: tale limite dipende dallo spessore dello strato di resist steso sul campione.
Per il bilayer 3%, dalle curve di contrasto (Bibl. 4) si ottiene uno spessore di 160nm: per uno strato di Al evaporato di 20nm la discontinuità è quindi garantita.
III.2.4 Attacco Ionico in Plasma
A
questo punto il campione subisce un passo di attacco ionico in plasma di Argon:
l'Al evaporato costituisce la maschera dell'![]() per l'attacco.
per l'attacco.
Gli
attacchi sui campioni dal II al XX, su S-test VII ed IE-test II (Tab. I) sono
stati condotti in modo tale da consumare completamente la maschera di Al, per
continuare sulla superficie di ![]() prima protetta, come schematizzato
in Fig. 4: lo spessore del gradino scavato nel substrato di
prima protetta, come schematizzato
in Fig. 4: lo spessore del gradino scavato nel substrato di ![]() rimane costante
dall'istante in cui la maschera è completamente rimossa, dal momento che la
superficie prima mascherata viene attaccata alla stessa velocità del resto del
substrato.
rimane costante
dall'istante in cui la maschera è completamente rimossa, dal momento che la
superficie prima mascherata viene attaccata alla stessa velocità del resto del
substrato.
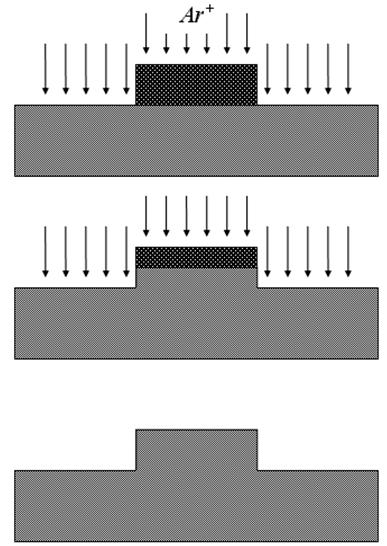
Fig. 4: L'attacco ionico in plasma è stato protratto fino alla rimozione completa della maschera di Al.
Sui campioni S-test IV e S-test VI l'attacco è stato fermato prima che la maschera di Al fosse stata completamente rimossa.
Per una prima calibrazione della velocità di attacco dell'Al sono stati attaccati anche dei campioni su cui non è stato compiuto il passo di litografia, ma solo quello di evaporazione termica:
 Tab. II
Tab. II
III.2.5 Attacco dell'Al e Misura degli Spessori
Per rimuovere
completamente ogni residuo di alluminio dal campione, questo viene sottoposto
ad un attacco umido isotropo in una soluzione con la seguente composizione
chimica: 80% in volume di acido ortofosforico (![]() ), 5% di acido nitrico (
), 5% di acido nitrico (![]() ), 5% di acido acetico (
), 5% di acido acetico (![]() ), 10% di acqua deionizzata. L'attacco è stato condotto alla
temperatura di 60°C.
), 10% di acqua deionizzata. L'attacco è stato condotto alla
temperatura di 60°C.
L'![]() è acido ortofosforico all'85% (PM=98), l'
è acido ortofosforico all'85% (PM=98), l'![]() è acido nitrico al 65% (PM=63.01), il
è acido nitrico al 65% (PM=63.01), il ![]() è acido acetico al
99.5%(PM=60.05) e l'acqua deionizzata è del deionizzatore Milli-Q (ACADEMIC).
è acido acetico al
99.5%(PM=60.05) e l'acqua deionizzata è del deionizzatore Milli-Q (ACADEMIC).
La
velocità di attacco dell'alluminio in tali condizioni è di circa ![]() : il tempo di attacco scelto è stato dunque di 6 minuti.
: il tempo di attacco scelto è stato dunque di 6 minuti.
Questo tempo di attacco non deve però essere preso rigorosamente in considerazione, perchè il ripetuto uso della soluzione ne degrada le prestazioni, diminuendone considerevolmente la velocità di attacco.
Gli spessori sono stati misurati con il profilometro a stilo ALPHA STEP 200 (TENCOR INSTRUMENTS).
III.2.6 Riepilogo del Processo
I passi di processo possono essere cosi riassunti e schematizzati:
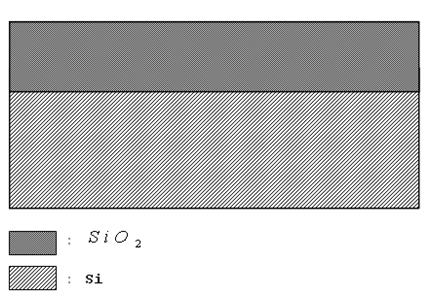
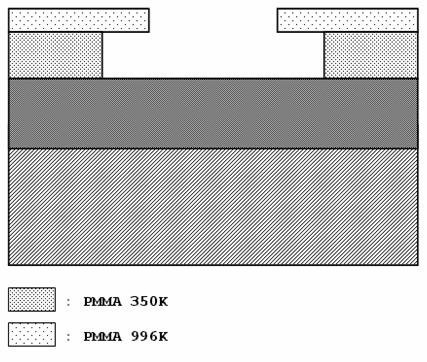
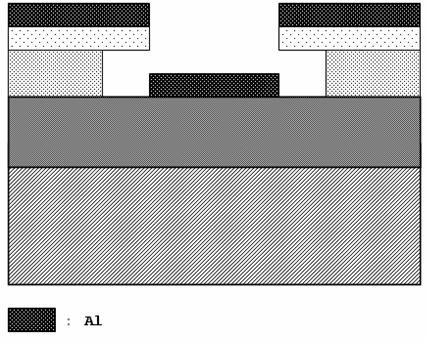
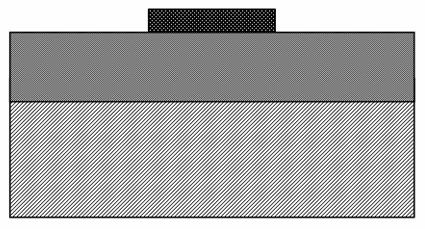
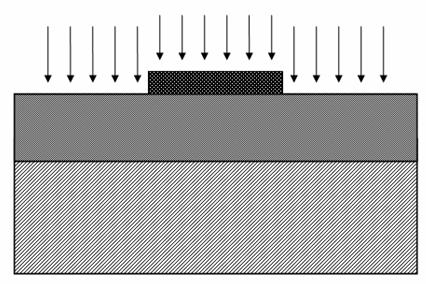
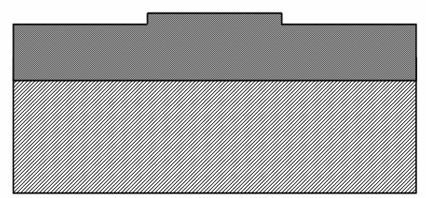
III.3 Ripetibilità e Precisione dell'Evaporazione Termica
In questo lavoro di tesi è stata verificata la precisione e la ripetibilità degli spessori evaporati. Sono state effettuate tre evaporazioni, per ciascuna delle quali la microbilancia dell'evaporatore ha indicato lo spessore di 20nm:

Tab. III
I campioni S-test IV, VI e VII hanno prima subito un passo di litografia EBL analogo a quello di tutti gli altri usati per calibrare la velocità di attacco dell'attacco ionico: dopo il lift-off, si è quindi potuto misurare lo spessore dello strato di Al evaporato con il microprofilometro a stilo.
Sono stati ottenuti i seguenti spessori:

Tab. IV
Si può quindi assumere come valore medio reale dello spessore del film di Al evaporato:
![]()
con una deviazione standard:
![]()
La
differenza tra il valor medio misurato con il microprofilometro (![]() ) e quello indicato dalla microbilancia (
) e quello indicato dalla microbilancia (![]() ) è stato considerato un offset dovuto a errori nella
calibrazione iniziale della microbilancia. Il suo valore è quindi costante ed
indipendente dagli spessori evaporati, e pari a:
) è stato considerato un offset dovuto a errori nella
calibrazione iniziale della microbilancia. Il suo valore è quindi costante ed
indipendente dagli spessori evaporati, e pari a:
![]()
I campioni Aog I, II e III sono comuni vetrini portaoggetti di spessore 0.8mm che, dopo il LAVAGGIO IN ULTRASUONI, hanno subito il passo di evaporazione termica dell'Al insieme ai campioni S-test IV, VI e VII rispettivamente: si sono così ottenuti degli specchi.
La ripetibilità degli spessori evaporati è stata testata misurando i coefficienti di trasmissione di tali specchi nella configurazione di Fig. 1.
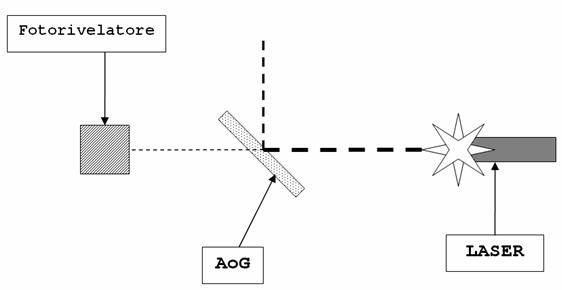
Fig. 1: Rappresentazione schematica della configurazione per la misura dei coefficienti di trasmissione degli specchi AoG I, II e III.
Sono stati impiegati il laser V9326 RS (194026) ed il fotorivelatore OPT301 (BURRBROWN), montati come descritto in Bibl. 5.
Le tensioni misurate in uscita al fotorivelatore su cui incide il raggio trasmesso (T) sono riportate in Tab. V (le misure sono state effettuate in camera oscura):

Tab. V
La ripetibilità del processo di evaporazione termica è stata giudicata soddisfacente.
III.4 Conclusioni sull'Attacco Ionico
Lo
scopo della caratterizzazione dell'attacco ionico in plasma di substrati di ![]() , mascherati da Al, è stato quello di ottenere un gradino
dello spessore di circa 20nm, minimizzando il danneggiamento della superficie
attaccata.
, mascherati da Al, è stato quello di ottenere un gradino
dello spessore di circa 20nm, minimizzando il danneggiamento della superficie
attaccata.
L'energia
degli ioni ![]() è stata quindi
progressivamente diminuita, agendo innanzitutto sulla potenza fornita dal
generatore, che è stata portata da 100W a 75W, ed infine a 50W, mantenendo
costante il flusso di Ar nella camera di reazione (e quindi la pressione della
camera) al valore di 15sccm. A potenza costante e pari a 50W, si è poi
aumentata la pressione della camera, portando il flusso da 15 a 30sccm.
è stata quindi
progressivamente diminuita, agendo innanzitutto sulla potenza fornita dal
generatore, che è stata portata da 100W a 75W, ed infine a 50W, mantenendo
costante il flusso di Ar nella camera di reazione (e quindi la pressione della
camera) al valore di 15sccm. A potenza costante e pari a 50W, si è poi
aumentata la pressione della camera, portando il flusso da 15 a 30sccm.
III.4.1 Spessori Ottenuti

Tab. VI
Tutti gli attacchi condotti a
potenza 100W e flusso 15sccm (Tab. VI) hanno portato alla completa rimozione
della maschera di Al: in queste condizioni lo spessore del gradino scavato nel
substrato di ![]() rimane costante al
variare del tempo di attacco.
rimane costante al
variare del tempo di attacco.
Lo spessore medio del gradino ottenuto con questi parametri di attacco vale:
![]()
con una deviazione standard:
![]()
Le superfici attaccate in questo modo sono state però trovate molto danneggiate, e quindi inadeguate.

Tab. VII
Gli attacchi condotti a potenza 50W e flusso 15sccm (Tab. VII) che hanno rimosso completamente la maschera di Al hanno generato gradini di spessore medio:
![]()
con una deviazione standard:
![]()
La selettività dell'attacco non è quindi cambiata, ma la qualità della superficie, attaccata da ioni meno energetici, è migliore.

Tab. VIII
Infine l' attacco condotto a potenza 50W e flusso 30sccm (Tab. VIII) che ha rimosso completamente la maschera di Al ha generato gradini di spessore medio:
![]()
con una deviazione standard:
![]()
Questo attacco costituisce il miglior compromesso tra regolarità delle superfici e spessori ottenuti.
III.4.2 Selettività
Per gli attacchi a (15sccm;50W) e (30sccm;50W), per i quali la regolarità delle superfici attaccate è stata giudicata soddisfacente, si è stimato il tempo di attacco minimo per cui la maschera di Al sia completamente rimossa.
Sia
![]() il livello della
superficie di
il livello della
superficie di ![]() esposta al
bombardamento, rispetto al livello assunto all'inizio dell'attacco (t=0min): al
generico istante t dall'inizio dell'attacco, vale la relazione:
esposta al
bombardamento, rispetto al livello assunto all'inizio dell'attacco (t=0min): al
generico istante t dall'inizio dell'attacco, vale la relazione:
![]()
Sia ![]() il livello della
superficie della maschera di Al rispetto al livello assunto dalla superficie di
il livello della
superficie della maschera di Al rispetto al livello assunto dalla superficie di
![]() prima dell'attacco: al
generico istante t dall'inizio dell'attacco, vale la relazione:
prima dell'attacco: al
generico istante t dall'inizio dell'attacco, vale la relazione:
![]()
Dove ![]() è la funzione gradino
unitario.
è la funzione gradino
unitario.
Il termine ![]() è stato inserito per
tenere conto del fatto che su un film di Al esposto all'aria è sempre presente
uno strato di ossido nativo, l'
è stato inserito per
tenere conto del fatto che su un film di Al esposto all'aria è sempre presente
uno strato di ossido nativo, l'![]() , che viene attaccato molto più lentamente dell'Al: si è
ipotizzato che lo spessore dell'ossido sia trascurabile rispetto a quello
dell'Al
, che viene attaccato molto più lentamente dell'Al: si è
ipotizzato che lo spessore dell'ossido sia trascurabile rispetto a quello
dell'Al
Lo spessore di ![]() è casuale, quindi
è casuale, quindi ![]() è un variabile
aleatoria.
è un variabile
aleatoria.
Dal
momento che lo spessore del gradino scavato nel substrato di ![]() rimane costante
dall'istante
rimane costante
dall'istante ![]() (tempo di pareggio), al quale la maschera è stata completamente
rimossa, si può scrivere:
(tempo di pareggio), al quale la maschera è stata completamente
rimossa, si può scrivere:
![]()
ovvero è pari a quello misurato.
Per la maschera invece vale:
![]()
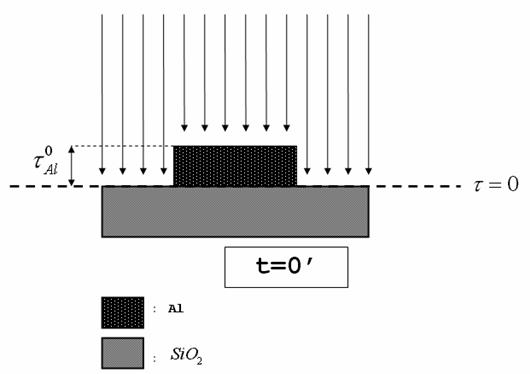
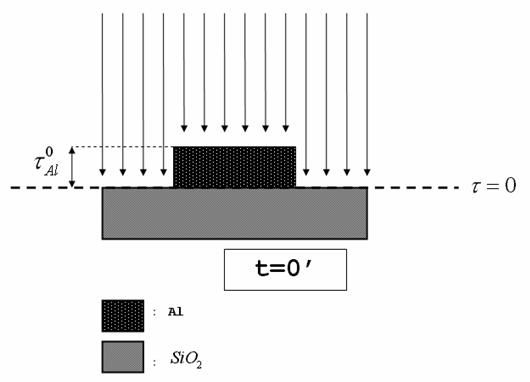
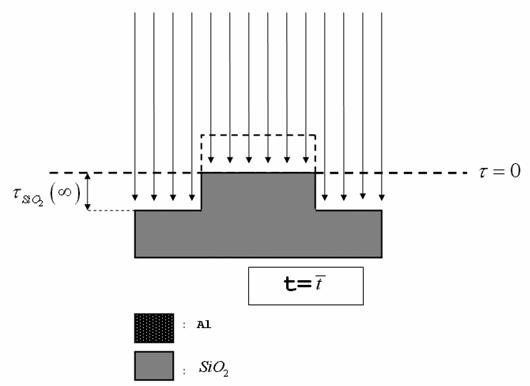
Fig. 1: Illustrazione delle e a vari istanti di tempo.
Le incognite sono dunque quattro: ![]() ,
, ![]() ,
, ![]() e
e ![]() : se si riesce ad ottenere il valore di
: se si riesce ad ottenere il valore di ![]() e
e ![]() ad un generico istante
ad un generico istante
![]() , si possono determinare risolvendo il sistema:
, si possono determinare risolvendo il sistema:

Si considerino i dati relativi all'attacco a 15sccm;50W:

Tab. IX
Con tali valori, dal sistema si ottengono le seguenti stime:

La selettività vale quindi:
![]()
Il valore di ![]() per
per ![]() è confermato anche
dagli attacchi compiuti su campioni non litografati (Tab. II).
è confermato anche
dagli attacchi compiuti su campioni non litografati (Tab. II).

Fig. 2: Andamento nel tempo di ![]() e
e ![]() durante l'attacco di
parametri 15sccm;50W
durante l'attacco di
parametri 15sccm;50W
Si considerino i dati relativi all'attacco a 30sccm;50W:

Tab. X
Per tali valori, il sistema fornisce:

Per la selettività si ottiene quindi:
![]()
Il
valore di ![]() per
per ![]() è confermato anche
dagli attacchi compiuti su campioni non litografati (Tab. II).
è confermato anche
dagli attacchi compiuti su campioni non litografati (Tab. II).
Si deve infine notare che è stato
assunto come valore reale dello spessore iniziale della maschera di Al quello
nominale, fornito dalla microbilancia dell'evaporatore: ![]() .
.

Fig. 3: Andamento nel tempo di ![]() e
e ![]() durante l'attacco di
parametri 30sccm;50W
durante l'attacco di
parametri 30sccm;50W
La
stima del tempo di pareggio ![]() , al quale la maschera è stata completamente rimossa, dà
un'importante indicazione nella scelta di un tempo di attacco tale che la
maschera sia rimossa di sicuro, senza che si danneggi inutilmente la superficie
e si aggravino gli effetti della rideposizione.
, al quale la maschera è stata completamente rimossa, dà
un'importante indicazione nella scelta di un tempo di attacco tale che la
maschera sia rimossa di sicuro, senza che si danneggi inutilmente la superficie
e si aggravino gli effetti della rideposizione.
BIBLIOGRAFIA
 |
| Appunti su: profilometro a stilo alpha-step D-500, |
|
| Appunti costruzione |  |
| Tesine Ingegneria tecnico |  |
| Lezioni Gestione |  |