 |
|
| Appunti scientifiche |
|
 |
|
| Appunti scientifiche |
|
| Visite: 2114 | Gradito: |
Leggi anche appunti:Gli orbitaliGli orbitali Ma che utilità ha per noi la funzione d'onda ψ che è una Materiali polimericiMATERIALI POLIMERICI SONO MATERIALI COMPOSTI DA CATENE MOLECOLARI LUNGHISSIME, Alcheni (Olefine) |
 |
 |
REALIZZAZIONE DELLA DOPPIA GIUNZIONE TUNNEL
La
caratterizzazione dell'attacco ionico in plasma dell'![]() , mascherato da Al, e dell'attacco umido anisotropo in KOH
del Si (110), mascherato da
, mascherato da Al, e dell'attacco umido anisotropo in KOH
del Si (110), mascherato da ![]() , ha avuto come fine la messa a punto di due processi per la
realizzazione della giunzione tunnel doppia.
, ha avuto come fine la messa a punto di due processi per la
realizzazione della giunzione tunnel doppia.
Il
primo processo (processo dry) sfrutta l'attacco dry in plasma per la
fabbricazione di giunzioni tunnel ![]() .
.
Il
secondo processo (processo wet) sfrutta l'attacco umido in KOH per la
fabbricazione di giunzioni tunnel ![]() .
.
Sono stati proposti molti approcci per la fabbricazione di giunzioni tunnel di dimensioni nanometriche. Per quanto riguarda i sistemi metallici, i principali sono il metodo dell'evaporazione ombra, il processo SAIL (Self Aligned In Line), ed il SECO (Step Edge Cut Off).
In questo lavoro di tesi è stato deciso di adottare quest'ultima tecnica per la realizzazione delle giunzioni tunnel dei dispositivi.
Per giustificare tale scelta, prima di presentare i dettagli della realizzazione dei dispositivi, saranno in breve discusse le tre suddette tecniche.
I Tecniche di Realizzazione
I.1 Metodo dell'Evaporazione Ombra
La tecnica dell'evaporazione ombra (G. J. Dolan, 1977)è stata la prima ad essere impiegata per la fabbricazione di dispositivi a singolo elettrone basati su sistemi metallici ed è attualmente la più diffusa.
Il passo critico per il successo del processo è quello che permette la sospensione di segmenti estesi di una maschera di resist ad una certa distanza dal substrato. Nei comuni processi di lift-off, i film sono definiti evaporando il metallo attraverso le aperture nella maschera ad incidenza normale al substrato, in modo da assicurare la rottura tra le parti dello strato sul substrato e quelle sulla maschera.
Se la maschera è sospesa, non è più necessario deporre il metallo ad incidenza normale per assicurare il successo del lift-off.
Come mostrato in Fig. 1, si può variare l'angolo di deposizione per ottenere diverse alterazioni dell'immagine della maschera.
La Fig. 1 mostra la sezione
trasversa della maschera considerata: essa è costituita da uno stato di
supporto di spessore ![]() , su cui è steso lo strato su cui sono definite le strutture,
di spessore
, su cui è steso lo strato su cui sono definite le strutture,
di spessore ![]() .
.
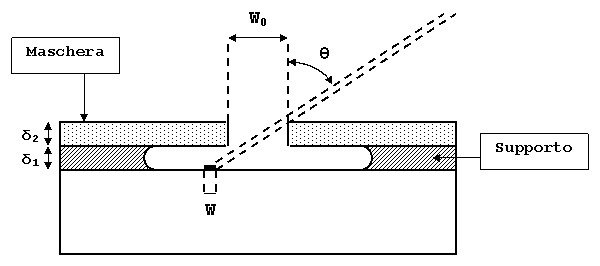
Fig. 1: Sezione trasversa della maschera per l'evaporazione ombra.
Si può praticare
nello strato superiore un'apertura di larghezza ![]() per produrre un film
di larghezza rispetto a
per produrre un film
di larghezza rispetto a ![]() , conducendo l'evaporazione ad un angolo
, conducendo l'evaporazione ad un angolo ![]() rispetto alla normale
al substrato.
rispetto alla normale
al substrato.
Se l'angolo di incidenza è maggiore di quello critico:

l'apertura nella maschera viene "chiusa": il metallo evaporato quindi non arriva sul substrato.
La realizzazione pratica di questo effetto ombra dipende dalla possibilità di realizzare maschere simili a quelle ideali finora presentate.
È importante che i
valori di ![]() e
e ![]() siano affidabili, e
che la sezione trasversa dello strato di resist superiore sia rettangolare.
siano affidabili, e
che la sezione trasversa dello strato di resist superiore sia rettangolare.
Per la realizzazione di giunzioni tunnel, si deve innanzitutto realizzare una maschera che presenti due aperture molto ravvicinate: tra di esse viene quindi definito un ponte sospeso di resist dello strato superiore.
Si procede poi alla
fabbricazione di giunzioni tunnel ![]() con una sequenza di
deposizione-ossidazione-deposizione, che avviene nello stesso ciclo di vuoto.
Dopo la prima evaporazione, effettuata ad un angolo
con una sequenza di
deposizione-ossidazione-deposizione, che avviene nello stesso ciclo di vuoto.
Dopo la prima evaporazione, effettuata ad un angolo ![]() (Fig. 2(a)), il film
deposto viene ossidato in un'atmosfera di
(Fig. 2(a)), il film
deposto viene ossidato in un'atmosfera di ![]() : si cresce uno strato di ossido di alluminio
: si cresce uno strato di ossido di alluminio ![]() di circa 1nm (Fig.
2(b)). Dopo aver svuotato di nuovo la camera dell'evaporatore, viene deposto il
secondo strato ad un angolo
di circa 1nm (Fig.
2(b)). Dopo aver svuotato di nuovo la camera dell'evaporatore, viene deposto il
secondo strato ad un angolo ![]() (Fig. 2(c)).
(Fig. 2(c)).
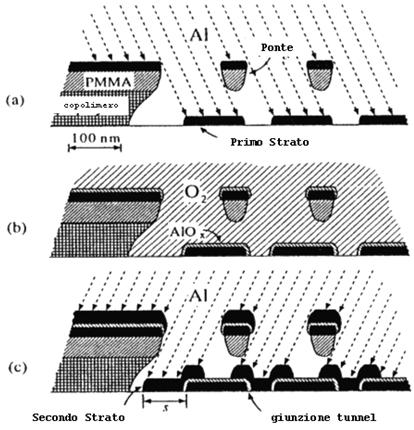
Fig. 2: Rappresentazione della sequenza deposizione-ossidazione-deposizione.
Per il diverso
angolo di evaporazione, i due gruppi di isole sono spostati di s l'uno rispetto all'altro, in modo
tale che possano parzialmente sovrapporsi: l'![]() crea una barriera tunnel tra le isole del primo e del
secondo strato evaporato.
crea una barriera tunnel tra le isole del primo e del
secondo strato evaporato.
I.2 Processo Self Aligned In Line (SAIL)
Il principio della tecnica SAIL (H. Koch, 1987) è quello di fabbricare le giunzioni tunnel ai due lati dell'isola, in modo che le dimensioni della giunzione coincidano con lo spessore e la larghezza minimi tra quelli dei film metallici: si ottiene dunque una configurazione planare con barriere verticali.
Il processo SAIL consiste nei seguenti passi:
i. Preparazione di un film metallico stretto e sottile sul substrato (Fig. 1(a)).
ii. Generazione di una maschera di resist che lasci scoperta l'area del futuro contro elettrodo (Fig. 1(b)).
iii. Attacco anisotropo del film che definisce l'isola(Fig. 1(c)).
iv. Formazione di una barriera dielettrica sulla superficie esposta dell'isola (Fig. 1(d)).
v. Deposizione del secondo film metallico (Fig. 1(e)).
vi. Lift off (Fig. 1(f)).

Fig. 1: Processo SAIL per la preparazione di due giunzioni tunnel in serie (tipo wnw).
La deposizione del metallo dalla quale poi si ricaverà l'isola si può realizzare per sputtering o evaporazione, e il seguente trasferimento del pattern può essere compiuto con lift off o attacco anisotropo.
La maschera generata nel secondo passo definisce la posizione e le dimensioni sia dell'isola, che degli elettrodi di source e drain. Il processo è autoallineato nella direzione della lunghezza dell'isola, mentre disallineamenti nella direzione traversa possono essere facilmente compensati definendo una delle due metal di larghezza maggiore: si può quindi fabbricare un'isola stretta in mezzo a due elettrodi larghi (wnw), come mostrato in Fig. 1, o un'isola larga in mezzo a due elettrodi stretti (wnw), senza in ogni caso variare l'area della giunzione tunnel.
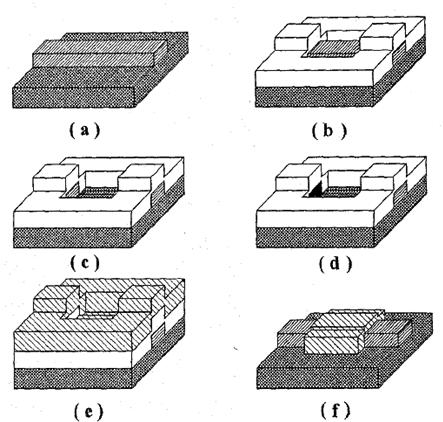
Fig. 2: Processo SAIL per la preparazione di due giunzioni tunnel in serie (tipo nwn).
Potrebbero sorgere delle difficoltà dall'uso di una stessa maschera per l'attacco ed il lift off: infatti il resist deve rimanere abbastanza spesso e solubile da permettere un lift off affidabile, anche dopo aver subito l'attacco ion beam. Si dovrà quindi aumentare lo spessore del resist a seconda delle velocità di attacco relative del resist e del metallo, e dello spessore di quest'ultimo.
La soluzione può essere quella di sostituire l'attacco ion beam, puramente fisico, con un attacco RIE, impiegando un gas con selettività chimica, che migliori quindi il rapporto tra le velocità di attacco. Un'altra soluzione è quella di usare una maschera multistrato, che consiste in due strati di resist, separati da uno strato intermedio che ha una velocità di attacco minore del resist: il resist più in basso viene quindi protetto, e può essere quindi usato come maschera per il lift off.
Dal momento che deve essere usata per il lift off, la maschera di resist deve presentare in sezione dei fronti a pendenza negativa. La generazione di una maschera adatta è il passo cruciale e più complicato della tecnica SAIL.
La barriera viene creata dopo l'attacco anisotropo della prima maschera: in questo modo si evita di danneggiarla con gli ioni ad alta energia.
Possono sorgere seri problemi di omogeneità della barriera a causa dell'overetching nel substrato durante il passo iii., che porta ad una rideposizione del materiale del substrato sui lati esposti dell'isola (Fig. (3)).
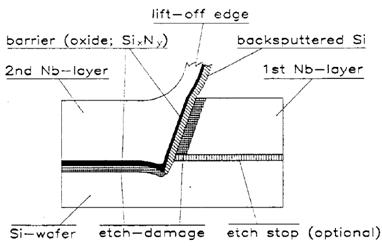
Fig. 3: Schema della sezione traversa reale di una
giunzione tunnel SAIL ![]() (Bibl. 1).
(Bibl. 1).
Per migliorare la qualità della barriera, oltre a rendere minimo l'overetching, si può lavorare su un substrato dello stesso materiale della barriera generata successivamente: si deve notare inoltre che i materiali per la barriera hanno di solito velocità di attacco minori dei corrispondenti metalli puri, e quindi possono formare degli eccellenti strati di stop.
La formazione di un contatto affidabile richiede che il grado di anisotropia dell'attacco (passo iii.) sia molto maggiore di quello della deposizione della seconda metal (passo vi.).
Se confrontato con la tecnica dell'evaporazione ombra, il processo SAIL presenta diversi vantaggi. Innanzitutto, c'è completa libertà nella scelta del processo di deposizione degli strati metallici. Inoltre non si devono realizzare strutture fragili come i ponti sospesi necessari per l'evaporazione ombra.
Infine, dal momento che la giunzione tunnel è realizzata ai lati dell'isola, gli elettrodi non si sovrappongono come quelli fabbricati con l'evaporazione ombra, e quindi la capacità di giunzione sarà minore.
Il primo SET realizzato con la tecnica SAIL è stato riportato da M. Gotz (1995).
Il dispositivo è basato sul sistema ![]() . L'isola, spessa 50nm e larga 80-150nm, è stata definita con
EBL su un monolayer di resist AR-P 610 e lift off. Il metallo è stato deposto
per sputtering. La seconda maschera è stata realizzata con un doppio strato di
resist: AR-P671 su AR-P 641. La seconda metal aveva uno spessore di 100nm.
L'attacco anisotropo è stato realizzato con ioni Ar. Immediatamente dopo l'attacco
è stata creata la barriera dielettrica con un passo di ossidazione in aria
secca. La resa riportata è del 40%.
. L'isola, spessa 50nm e larga 80-150nm, è stata definita con
EBL su un monolayer di resist AR-P 610 e lift off. Il metallo è stato deposto
per sputtering. La seconda maschera è stata realizzata con un doppio strato di
resist: AR-P671 su AR-P 641. La seconda metal aveva uno spessore di 100nm.
L'attacco anisotropo è stato realizzato con ioni Ar. Immediatamente dopo l'attacco
è stata creata la barriera dielettrica con un passo di ossidazione in aria
secca. La resa riportata è del 40%.
Dalla ampiezza della zona di Coulomb Blockade è stata stimata una
capacità di giunzione 0.5fF, che concorda con il valore stimato per una giunzione
tunnel di area ![]() , ed una barriera di spessore dell'ordine del nm.
, ed una barriera di spessore dell'ordine del nm.
I.3 Processo Step Edge Cut Off (SECO)
La
tecnica SECO prevede l'adozione di materiali per la fabbricazione delle
giunzioni tunnel alternativi al tradizionale sistema ![]() .
.
La scelta tra i diversi sistemi metallo/dielettrico/metallo possibili si fonda sul confronto tra gli spessori s della barriera tunnel. Tale confronto viene effettuato richiedendo che, sotto l'ipotesi di barriera rettangolare, la densità di corrente che attraversa la giunzione sia la stessa quando ad essa venga applicata la tensione:
![]()
che è la massima oltre la quale lo spessore effettivo della barriera comincia a diminuire.
Si
consideri l'espressione per la densità di corrente attraverso una barriera
tunnel rettangolare di altezza ![]() , in condizione di tensioni di polarizzazione intermedie (
, in condizione di tensioni di polarizzazione intermedie (![]() ) (Par. I.3.2 del Cap. I):
) (Par. I.3.2 del Cap. I):

La , sotto la condizione , diventa:

Se si fa l'approssimazione
di trascurare la variazione del fattore pre-esponenziale con s e ![]() , la richiesta che sotto la condizione la J sia la stessa per il sistema metallo/dielettrico/metallo
caratterizzato da spessore di barriera
, la richiesta che sotto la condizione la J sia la stessa per il sistema metallo/dielettrico/metallo
caratterizzato da spessore di barriera ![]() ed altezza
ed altezza ![]() e quello con spessore
e quello con spessore ![]() e barriera
e barriera ![]() porta a imporre:
porta a imporre:
![]()
Per innalzare la temperatura di funzionamento di un dispositivo a singolo elettrone è necessario ridurrne le capacità di giunzione: i problemi tecnologici non derivano infatti dalle capacità di gate, che possono essere ridotte arbitrariamente aumentando la distanza tra gli elettrodi.
Per rispettare la condizione , appare chiaro come un semplice aumento della distanza tra gli elettrodi di un condensatore tunnel non sia una scelta praticabile per la riduzione della capacità.
Usando
l'evaporazione ombra o il SAIL per realizzare condensatori tunnel ![]() , l'unico modo ragionevole di ridurne la capacità è quindi ridurre
la larghezza delle piste di metallo. Se però si realizzano giunzioni tunnel
usando materiali tali che l'altezza della barriera che gli elettroni devono
attraversare sia significativamente minore di quella che presenta la giunzione
, l'unico modo ragionevole di ridurne la capacità è quindi ridurre
la larghezza delle piste di metallo. Se però si realizzano giunzioni tunnel
usando materiali tali che l'altezza della barriera che gli elettroni devono
attraversare sia significativamente minore di quella che presenta la giunzione ![]() , diventa possibile aumentare la distanza tra gli elettrodi,
senza provocare una diminuzione della corrente che attraversa il condensatore
tunnel.
, diventa possibile aumentare la distanza tra gli elettrodi,
senza provocare una diminuzione della corrente che attraversa il condensatore
tunnel.

Tab. I: Altezze di barriera per diverse possibili coppie di materiali da usare per realizzare una giunzione tunnel.
Osservando la Tab. I, è chiaro come, passando da una giunzione ![]() , ad una
, ad una ![]() , si possa rendere la distanza tra gli elettrodi fino a cinque
volte maggiore. A parità di area A del condensatore tunnel, la capacità si
riduce quindi di
, si possa rendere la distanza tra gli elettrodi fino a cinque
volte maggiore. A parità di area A del condensatore tunnel, la capacità si
riduce quindi di ![]() rispetto
all'originale.
rispetto
all'originale.
L'impiego di
materiali con altezze di barriera significativamente ridotte permette di
ridurre la capacità di giunzione anche in un altro modo. Le barriere ![]() hanno tipicamente uno
spessore di
hanno tipicamente uno
spessore di ![]() : usando
: usando ![]() lo spessore si può
portare a
lo spessore si può
portare a ![]() . Se lo spessore della barriera è dell'ordine di
. Se lo spessore della barriera è dell'ordine di ![]() , non è più necessario realizzare condensatori piani: se si
evapora metallo su uno scalino costituito di materiale di barriera, la metal si
interromperà sul bordo dello scalino: questo è il principio del processo SECO.
, non è più necessario realizzare condensatori piani: se si
evapora metallo su uno scalino costituito di materiale di barriera, la metal si
interromperà sul bordo dello scalino: questo è il principio del processo SECO.
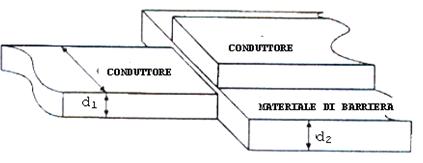
Fig. 1: Il metallo di spessore ![]() viene evaporato su uno
scalino costituito di materiale di barriera, di spessore
viene evaporato su uno
scalino costituito di materiale di barriera, di spessore ![]() . Se
. Se ![]() i due elettrodi non
hanno contatti sul bordo dello scalino, e la corrente scorrerà per tunneling.
i due elettrodi non
hanno contatti sul bordo dello scalino, e la corrente scorrerà per tunneling.
La capacità di questa giunzione tunnel è drasticamente minore di quella a facce piane parallele, anche se la larghezza delle metal è maggiore.
Il processo SECO, così come è stato presentato per la prima volta da S.
Altmeyer (1995), impiegava ![]() come metallo, e
come metallo, e ![]() come materiale per il
gradino.
come materiale per il
gradino.
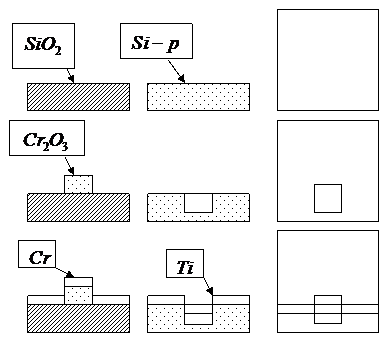
Fig. 2: Processo di fabbricazione SECO di un SET. A sinistra è mostrato il processo additivo per il sistema: metallo/ossido del metallo/metallo. In centro è mostrato il processo sottrattivo per il sistema: metallo/semiconduttore/metallo.
Il primo passo è la
definizione con EBL in un monolayer di resist PMMA della finestra per il lift
off del ![]() , evaporato tramite EBE (Electron Beam Evaporation). La metal
di
, evaporato tramite EBE (Electron Beam Evaporation). La metal
di ![]() viene definita con una
secondo passo di EBL ed un secondo lift off.
viene definita con una
secondo passo di EBL ed un secondo lift off.
La Fig. 3 mostra il
primo SET ![]() fabbricato con il
metodo SECO: l'ampiezza della zona di Coulomb Blockade (che è evidente fino a
15K) corrisponde ad una capacità di 26aF, la più bassa capacità realizzata in
una struttura metallica al tempo. È importante sottolineare che questa capacità
è stata raggiunta con un'EBL di risoluzione relativamente bassa: gli elettrodi
sono infatti larghi più di 150nm.
fabbricato con il
metodo SECO: l'ampiezza della zona di Coulomb Blockade (che è evidente fino a
15K) corrisponde ad una capacità di 26aF, la più bassa capacità realizzata in
una struttura metallica al tempo. È importante sottolineare che questa capacità
è stata raggiunta con un'EBL di risoluzione relativamente bassa: gli elettrodi
sono infatti larghi più di 150nm.

Fig. 3: SET con giunzioni tunnel ![]() , realizzato con il processo SECO additivo. L'elettrodo
destro e sinistro sono il source ed il drain, mentre quello in alto è il gate.
L'isola è sopra il gradino di
, realizzato con il processo SECO additivo. L'elettrodo
destro e sinistro sono il source ed il drain, mentre quello in alto è il gate.
L'isola è sopra il gradino di ![]() .
.
Il punto debole del
sistema ![]() è che la
riproducibilità del dispositivo non è soddisfacente a causa del fatto che il
è che la
riproducibilità del dispositivo non è soddisfacente a causa del fatto che il ![]() evaporato non bagna
l'ossido, e quindi il contatto tra il metallo ed il materiale della barriera
non è abbastanza stretto.
evaporato non bagna
l'ossido, e quindi il contatto tra il metallo ed il materiale della barriera
non è abbastanza stretto.
Un'alternativa che ha mostrato una
maggiore riproducibilità è il sistema titanio (![]() )-silicio p: è noto infatti che il
)-silicio p: è noto infatti che il ![]() forma sul silicio dei
film molto regolari, che aderiscono ottimamente, e che il
forma sul silicio dei
film molto regolari, che aderiscono ottimamente, e che il ![]() tende a bagnare il
silicio.
tende a bagnare il
silicio.
Si può usare
silicio come materiale dielettrico di barriera perché a temperature basse si
comporta da isolante: inoltre, dal momento che ![]() e
e ![]() formano un contatto
Shottky di altezza di barriera
formano un contatto
Shottky di altezza di barriera ![]() , un contatto
, un contatto ![]() è isolante anche a
temperature più alte.
è isolante anche a
temperature più alte.
Come mostrato in
Fig. 2, è stato scavato un buco nel Si-p con un attacco RIE (Reactive Ion
Etching) in ![]() , usando come maschera un monolayer di PMMA litografato con
EBL. Le metal di
, usando come maschera un monolayer di PMMA litografato con
EBL. Le metal di ![]() sono state prodotte
con un secondo passo di litografia, evaporazione tramite EBE e lift off.
sono state prodotte
con un secondo passo di litografia, evaporazione tramite EBE e lift off.
Il punto più critico del processo SECO è accordare lo spessore del metallo evaporato alla profondità dello scavo nel substrato. Se infatti la deposizione del metallo può facilmente essere controllata in situ con grande precisione per mezzo di un oscillatore al quarzo, lo spessore dello scavo ha una riproducibilità peggiore. Su ogni chip è stato quindi prodotto uno scavo di riferimento la cui profondità potesse essere facilmente misurata: lo spessore del metallo da evaporare poteva essere determinato in base a tale misura. Con questa procedura S. Altmeyer riporta di aver ottenuto una resa dell'80%.

Fig. 4: SET con giunzioni tunnel ![]() , realizzato con il processo SECO sottrattivo. L'elettrodo
destro e sinistro sono il source ed il drain, mentre quello in alto è il gate.
L'isola è dentro lo scavo nel
, realizzato con il processo SECO sottrattivo. L'elettrodo
destro e sinistro sono il source ed il drain, mentre quello in alto è il gate.
L'isola è dentro lo scavo nel ![]()
La Fig. 4 mostra il SET ![]() fabbricato con il
metodo SECO. L'ampiezza della zona di Coulomb Blockade (che è evidente fino a
77K) corrisponde ad una capacità di giunzione di 1.5aF, valore raggiunto con
delle metal di 75nm di larghezza.
fabbricato con il
metodo SECO. L'ampiezza della zona di Coulomb Blockade (che è evidente fino a
77K) corrisponde ad una capacità di giunzione di 1.5aF, valore raggiunto con
delle metal di 75nm di larghezza.
I metodi di fabbricazione tradizionali richiederebbero una risoluzione del processo litografico inferiore ai 10nm per raggiungere capacità di questo ordine.
BIBLIOGRAFIA
 |
| Appunti su: appuntimania, https:wwwappuntimaniacomscientifichechimicarealizzazione-della-doppia-giu63php, |
|
| Appunti Ingegneria tecnico |  |
| Tesine Geografia |  |
| Lezioni Biologia |  |