 |
|
| Appunti scientifiche |
|
 |
|
| Appunti scientifiche |
|
| Visite: 1114 | Gradito: |
Leggi anche appunti:L'elettrodeposizioneL'ELETTRODEPOSIZIONE Scopo: Verificare cosa comporta il flusso di corrente Chimica organicaCHIMICA ORGANICA Tipi di legame carbonio-carbonio: Per il carbonio esistono La teoria quantistica e la struttura atomicaLa teoria quantistica e la struttura atomica 1 L'energia di prima ionizzazione |
 |
 |
Il Processo Wet
In
questo lavoro di tesi è stato pensato anche un secondo processo di
realizzazione della doppia giunzione tunnel SECO, che sfrutta l'attacco umido
anisotropo del Si con orientazione ![]() ,
in soluzioni di
,
in soluzioni di ![]() e
e ![]() .
.
La strategia di realizzazione del dispositivo è analoga alla tecnica sottrattiva proposta da Altmayer (Fig. 2 del par. I.3): dopo aver effettuato uno scavo nel substrato di Si con l'attacco in KOH, si evapora uno strato di Al di spessore opportuno, in modo tale che questo si spezzi sui suoi spigoli(Fig. 1).
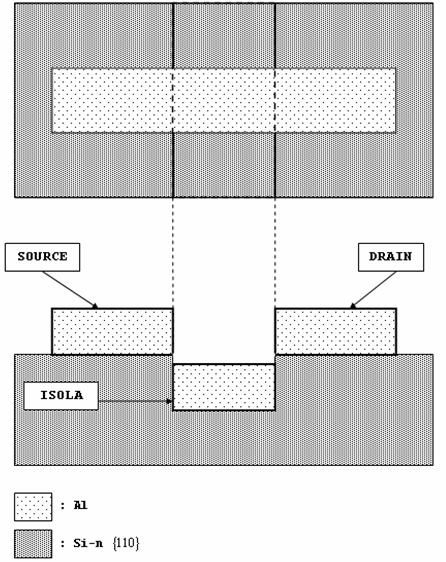
Fig. 1: Rappresentazione schematica della doppia giunzione tunnel SECO realizzata con il processo wet: vista in sezione ed in pianta.
Le giunzioni tunnel realizzate saranno quindi: ![]() .
Si può usare silicio come materiale dielettrico di barriera perché a
temperature basse, come quelle a cui ci si aspetta che il dispositivo funzioni,
si comporta da isolante: inoltre, dal momento che Al e
.
Si può usare silicio come materiale dielettrico di barriera perché a
temperature basse, come quelle a cui ci si aspetta che il dispositivo funzioni,
si comporta da isolante: inoltre, dal momento che Al e ![]() formano un contatto Shottky di altezza di
barriera
formano un contatto Shottky di altezza di
barriera ![]() ,
un contatto
,
un contatto ![]() è isolante anche a temperature più alte.
è isolante anche a temperature più alte.
Realizzazione della Doppia Giunzione Tunnel
La sequenza di processo per la realizzazione della doppia giunzione tunnel, eseguita con successo una sola volta (campione 534), è di seguito riportata.
Preparazione dei campioni
Innanzitutto
un wafer di Si Czochralski da 3 pollici di tipo n con orientazione ![]() ,
spessore 356-406
,
spessore 356-406![]() e resistività per quadro 1-20
e resistività per quadro 1-20![]() viene pulito con il LAVAGGIO IN ULTRASUONI.
viene pulito con il LAVAGGIO IN ULTRASUONI.
Con un passo di OSSIDAZIONE TERMICA DRY o WET, viene cresciuto uno spessore di 60 nm di ossido.
Infine, esso viene tagliato come descritto nel Par. III.1.2 del Cap. III, per ricavarne campioni di dimensioni opportune.
Realizzazione dei markers
A questo punto sul campione vengono realizzati i markers.
Il campione subisce quindi il primo passo di litografia EBL: dopo la stesura del BILAYER 6%, si scrive su di esso ad ingrandimento 40X la seguente geometria:

Fig. 1: Maschera 1: Markers.
I markers vengono allineati con un lato parallelo ad uno dei piani ![]() ortogonali al
substrato (Fig. 2).
ortogonali al
substrato (Fig. 2).
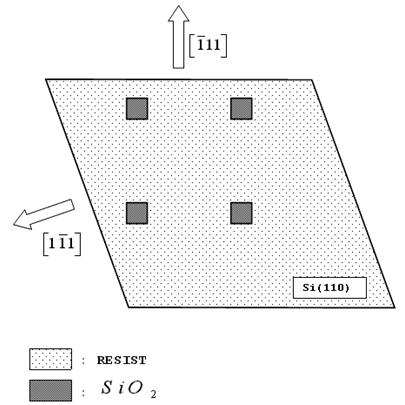
Fig. 2: Rappresentazione schematica della vista dall'alto di un
campione dopo il primo passo di litografia: le aree rettangolari più scure sono
quelle in cui il resist è stato impresso e sviluppato, lasciando scoperto l'![]()
L'allineamento
angolare viene compiuto manualmente, allineandosi ad ingrandimento 550X sul
bordo del campione ortogonale alla direzione ![]() .
.
Dopo lo sviluppo, si procede
all'attacco in BHF dell'![]() per 75 secondi, dopodiché si effettua lo strip del resist,
immergendo il campione in acetone e risciacquandolo in IPA.
per 75 secondi, dopodiché si effettua lo strip del resist,
immergendo il campione in acetone e risciacquandolo in IPA.
A questo punto si conduce un attacco
in una soluzione di ![]() al 35% in peso di KOH,
alla temperatura di 45°C, per 15min.
al 35% in peso di KOH,
alla temperatura di 45°C, per 15min.
Gli scavi prodotti
con questi parametri di attacco hanno una profondità di circa ![]() (Tab. III nel Par.
III.1.8 del Cap. III), che è sufficiente a garantire il contrasto necessario
perchè la procedura di allineamento abbia successo.
(Tab. III nel Par.
III.1.8 del Cap. III), che è sufficiente a garantire il contrasto necessario
perchè la procedura di allineamento abbia successo.
Definizione dello scavo
Dopo la stesura del il BILAYER 1.5%, si scrive a ingrandimento 400X la seguente geometria:

Fig. 3 Maschera 2: Scavo nel Si.
L'allineamento traslazionale viene effettuato sui markers prodotti al passo precedente per mezzo della procedura di allineamento per markers negativi.
L'allineamento angolare è ancora manuale: la geometria scritta viene
allineata con il lato maggiore parallelo ad uno dei piani ![]() ortogonali al
substrato.
ortogonali al
substrato.
Dopo lo sviluppo, si procede
all'attacco in BHF dell'![]() per 75 secondi a temperatura ambiente, dopodiché si effettua
lo strip del resist, immergendo il campione in acetone e risciacquandolo in
IPA.
per 75 secondi a temperatura ambiente, dopodiché si effettua
lo strip del resist, immergendo il campione in acetone e risciacquandolo in
IPA.
Il passo successivo è la definizione
di uno scavo a parerti verticali nel substrato di Si con l'attacco in una
soluzione ![]() al 35% in peso di KOH, alla temperatura di
38°C (mantenuta costante nel bagno termostato HAAKE DC50 (ENCO)):
considerando infatti i dati ottenuti dalle prove per la caratterizzazione
dell'attacco in KOH, questa scelta è stata giudicata un buon compromesso tra
velocità di attacco e regolarità delle superfici dello scavo
al 35% in peso di KOH, alla temperatura di
38°C (mantenuta costante nel bagno termostato HAAKE DC50 (ENCO)):
considerando infatti i dati ottenuti dalle prove per la caratterizzazione
dell'attacco in KOH, questa scelta è stata giudicata un buon compromesso tra
velocità di attacco e regolarità delle superfici dello scavo
In base ai dati raccolti, la velocità di attacco in queste condizioni è:
![]()
L'attacco viene condotto per 105 secondi, quindi la profondità attesa è di:
![]()
La profondità
misurata è ![]() (Fig. 4): la
discrepanza con il valore di
(Fig. 4): la
discrepanza con il valore di ![]() è stata attribuita al
fatto che la velocità di attacco nei primi secondi è inferiore a quella stimata.
è stata attribuita al
fatto che la velocità di attacco nei primi secondi è inferiore a quella stimata.
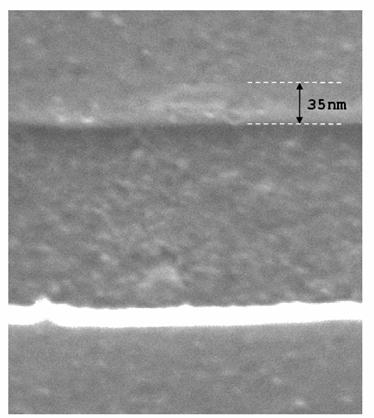
Fig. 4: Immagine dello scavo nel Si, ottenuta ruotando il campione di -30° (campione 534).
La larghezza dello scavo ottenuto è di 450nm.
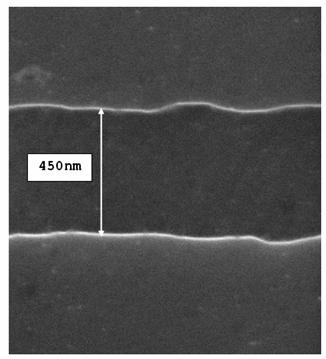
Fig. 5:Lo scavo nel Si ![]() .
.
Il passo successivo è la rimozione
dell'![]() : si procede quindi all'attacco in BHF dell'
: si procede quindi all'attacco in BHF dell'![]() per 2 minuti a temperatura ambiente.
per 2 minuti a temperatura ambiente.
Fabbricazione della giunzione tunnel
Sul campione viene steso il BILAYER 3%: dopo aver compiuto l'allineamento sui markers, si scrive a ingrandimento 400X la seguente geometria:

Fig. 6: Maschera 3: film di Al di spessore calibrato.
Dopo lo sviluppo,
si procede all' all'EVAPORAZIONE
TERMICA di Al a ![]() .
.
Perché il film si rompa effettivamente sugli spigoli dello scavo nel
Si, lo spessore evaporato deve essere calibrato sulla profondità dello scavo, tenendo
conto dell'errore sistematico da cui è affetta la misura degli spessori
evaporati fornita dalla microbilancia dell'evaporatore termico: ![]() .
.
Per ottenere una barriera tunnel dello spessore di ![]() , considerando che (Fig. 7):
, considerando che (Fig. 7):
![]()
si è scelto quindi
di evaporare uno spessore nominale ![]() di Al.
di Al.
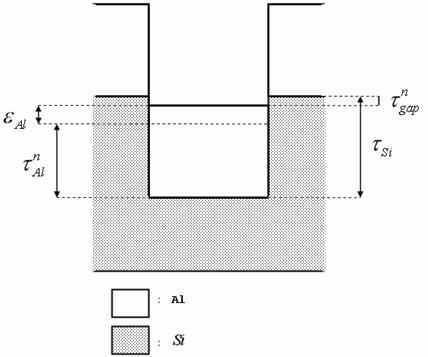
Fig. 7: Rappresentazione della relazione tra gli spessori.
Il valore stimato
per lo spessore della barriera è molto vicino a quello misurato: ![]() (Fig. 8).
(Fig. 8).
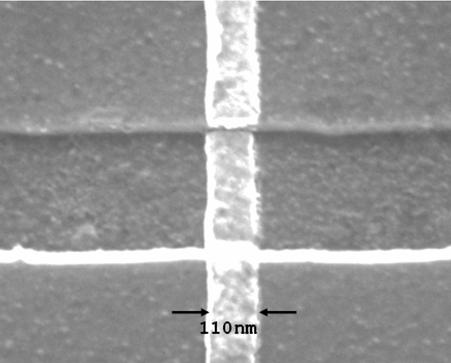
Fig. 8: Rottura del film di Al sullo spigolo dello scavo (campione 534).
La larghezza del film di Al è di 110nm.
Evaporazione dei pads
Sul campione viene steso il BILAYER 6%: dopo aver compiuto l'allineamento sui markers, si scrive a ingrandimento 40X la seguente geometria:
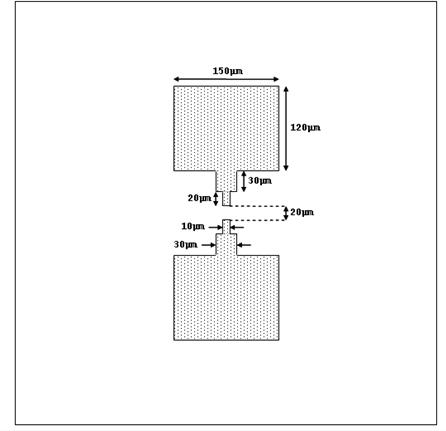
Fig. 9: Maschera 4: pads.
Segue lo sviluppo,
l'EVAPORAZIONE TERMICA di 30nm di Au (![]() ),
su 60nm di Al (
),
su 60nm di Al (![]() ),
ed il LIFT-OFF
),
ed il LIFT-OFF
In Fig. 10 sono mostrate insieme le quattro maschere impiegate nel processo:

Fig. 10: Le quattro maschere del processo per la realizzazione del dispositivo precursore.
Conclusioni sul Processo Wet
In questo lavoro di tesi ci si è concentrati sulla calibrazione della
profondità dello scavo nel Si ![]() e dello spessore del
film di Al che si deve spezzare sui suoi spigoli, piuttosto che sulla riduzione
delle dimensioni delle strutture
e dello spessore del
film di Al che si deve spezzare sui suoi spigoli, piuttosto che sulla riduzione
delle dimensioni delle strutture
Tale scelta è dovuta alle seguenti ipotesi:
Gli spessori scelti
per lo scavo (![]() ) ed il film di Al (
) ed il film di Al (![]() ) limitano inferiormente il minimo spessore del resist che
può essere steso perchè il processo di lift-off al passo (iv.) abbia successo.
Imponendo quale sia il processo litografico da usare,
) limitano inferiormente il minimo spessore del resist che
può essere steso perchè il processo di lift-off al passo (iv.) abbia successo.
Imponendo quale sia il processo litografico da usare, ![]() e
e ![]() limitano dunque
inferiormente la minima larghezza del film di Al, che sarà appunto pari alla
minima raggiungibile con il processo litografico impiegato.
limitano dunque
inferiormente la minima larghezza del film di Al, che sarà appunto pari alla
minima raggiungibile con il processo litografico impiegato.
Lo spessore della
barriera tunnel ottenuto per un certo valore di ![]() e
e ![]() rimane costante con la
riduzione della dimensione caratteristica della giunzione.
rimane costante con la
riduzione della dimensione caratteristica della giunzione.
È quindi chiaro che,
mentre ![]() e
e ![]() influenzano la
dimensione caratteristica del dispositivo, non è vero il contrario: è perciò
sensato determinare prima questi, e poi scalare le dimensioni.
influenzano la
dimensione caratteristica del dispositivo, non è vero il contrario: è perciò
sensato determinare prima questi, e poi scalare le dimensioni.
Per ridurre la dimensione caratteristica del dispositivo si devono diminuire la larghezza dello scavo e del film di Al.
Riduzione della Larghezza dello Scavo
La larghezza dello scavo raggiunta con l'attuale processo (passo iii.) è di 450nm.
La misura effettuata sulla struttura scritta nel resist impiegato per il passo di litografia, il BILAYER 1.5%, ha fornito un valore inferiore ai 100nm (Fig. 1).
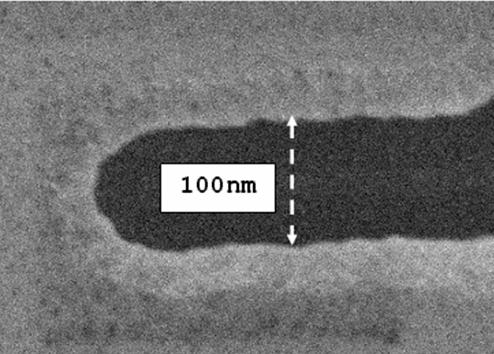
Fig. 1: Immagine della struttura scritta nel BILAYER 1.5%.
L'aumento delle dimensioni non deve essere imputato al disallineamento
angolare delle pareti dello scavo rispetto al piano ![]() , dovuto al blando allineamento angolare effettuato al passo
iii.: come anticipato nel Cap. III (Par III.1.6), l'aumento della larghezza
dello scavo dovuto al basso AR dell'attacco in
, dovuto al blando allineamento angolare effettuato al passo
iii.: come anticipato nel Cap. III (Par III.1.6), l'aumento della larghezza
dello scavo dovuto al basso AR dell'attacco in ![]() è dell'ordine del nm.
è dell'ordine del nm.
La causa è
piuttosto il sottoattacco creato al passo iii. dall'attacco isotropo in BHF
dell'![]() : infatti, dal momento che non è stata effettuata una
calibrazione rigorosa dei tempi di attacco, si attacca per un tempo superiore a
quello minimo, per cui si ha che
: infatti, dal momento che non è stata effettuata una
calibrazione rigorosa dei tempi di attacco, si attacca per un tempo superiore a
quello minimo, per cui si ha che ![]() (Par III.1.4 del Cap.
III).
(Par III.1.4 del Cap.
III).
Ciò che è opportuno
fare quindi per diminuire la larghezza dello scavo nel Si è calibrare l'attacco
in BHF rendendolo più affidabile: il che permetterà di avvicinare il tempo di
attacco a quello minimo per la rimozione di tutto l'![]() , e quindi l'overetch, in modo tale che sia:
, e quindi l'overetch, in modo tale che sia: ![]() . Il passo successivo dovrebbe essere una diminuzione di
. Il passo successivo dovrebbe essere una diminuzione di ![]() .
.
Infine, si può passare a calibrare i parametri di esposizione per minimizzare le dimensioni della struttura scritta nel BILAYER 1.5%.
Riduzione della Larghezza del Film di Al
La larghezza del film di Al raggiunta con l'attuale processo (passo iv.) è di 110nm.
Assumendo vere le
ipotesi a. e b., è sensato determinare prima i valori di ![]() e
e ![]() tali che lo spessore
della barriera tunnel
tali che lo spessore
della barriera tunnel ![]() sia quello desiderato
sia quello desiderato ![]() , e poi scalare la dimensione della pista di Al.
, e poi scalare la dimensione della pista di Al.
In base ai dati raccolti in questo lavoro di tesi, si stima che questo procedimento avrebbe successo.
Aggiungendo altre
ipotesi, si può però pensare di variare ![]() e
e ![]() per raggiungere il
per raggiungere il ![]() , in modo tale da permettere contemporaneamente anche di
ridurre la larghezza del film di Al: il risultato è che il numero di passi di
calibrazione del processo è minore.
, in modo tale da permettere contemporaneamente anche di
ridurre la larghezza del film di Al: il risultato è che il numero di passi di
calibrazione del processo è minore.
Le ipotesi aggiuntive sono:
Il successo del
lift-off è legato solo a ![]() e
e ![]() ed allo spessore del
resist steso, ed indipendente dal tipo di resist usato: 80nm di bilayer 1.5% è
quindi equivalente ai fini del lift-off a 80nm di bilayer 3%.
ed allo spessore del
resist steso, ed indipendente dal tipo di resist usato: 80nm di bilayer 1.5% è
quindi equivalente ai fini del lift-off a 80nm di bilayer 3%.
Il minimo spessore
di resist necessario perchè il lift-off non fallisca a causa dello scavo nel Si
e il minimo spessore di resist necessario perchè il lift-off non fallisca a
causa dell'evaporazione di Al sono funzioni monotone crescenti di ![]() e
e ![]() , rispettivamente:
, rispettivamente:

Lo spessore della barriera tunnel è una
funzione monotona crescente di ![]() :
: ![]()
Per la c., ![]() e
e ![]() sono indipendenti dal
tipo di resist impiegato. Per la e.
sono indipendenti dal
tipo di resist impiegato. Per la e. ![]() non varia se gli
spessori vengono ridotti della stessa quantità.
non varia se gli
spessori vengono ridotti della stessa quantità.
La procedura da seguire per variare ![]() o
o ![]() e raggiungere il
e raggiungere il ![]() in modo compatibile
con lo scaling del dispositivo è presentata di seguito:
in modo compatibile
con lo scaling del dispositivo è presentata di seguito:
var ![]() ;
; ![]() ;
; ![]() ;
;
![]() ;
; ![]() ;
;
const ![]() ;
; ![]() ;
;
![]() ;
;
![]() ;
;
![]() ;
;
if (![]() et
et ![]() ) goto::ENDok
) goto::ENDok
else goto::2.;
<Se lo spessore del film di Al evaporato (![]() ) e la profondità dello scavo nel Si (
) e la profondità dello scavo nel Si (![]() ) sono tali che il minimo spessore di resist necessario
perchè il lift-off non fallisca a causa dello scavo (
) sono tali che il minimo spessore di resist necessario
perchè il lift-off non fallisca a causa dello scavo (![]() ) e il minimo spessore di resist necessario perchè il
lift-off non fallisca a causa dell'evaporazione (
) e il minimo spessore di resist necessario perchè il
lift-off non fallisca a causa dell'evaporazione (![]() ) sono minori dello spessore del resist (
) sono minori dello spessore del resist (![]() )con cui è possibile raggiungere una risoluzione maggiore che
con quello attuale, la procedura termina con successo: adottando il nuovo
resist si diminuiranno le dimensioni del film di Al, lasciando invariato
)con cui è possibile raggiungere una risoluzione maggiore che
con quello attuale, la procedura termina con successo: adottando il nuovo
resist si diminuiranno le dimensioni del film di Al, lasciando invariato ![]() .>
.>
case(![]() ;
;![]() ;
;![]()
![]() et
et ![]() goto::3.;
goto::3.;
![]() et
et ![]() goto::4.;
goto::4.;
![]() ; goto::5.;
; goto::5.;
goto::ENDfail;
<Se si deve aumentare il gap (![]() ), si può
aumentare
), si può
aumentare ![]() , o diminuire
, o diminuire![]() . Si può effettuare una scelta dei nuovi spessori che sia compatibile
con lo scaling, solo se gli spessori attuali sono tali che
. Si può effettuare una scelta dei nuovi spessori che sia compatibile
con lo scaling, solo se gli spessori attuali sono tali che ![]() è minore di
è minore di ![]() .
.
Se si deve diminuire il gap (![]() ), si può
aumentare
), si può
aumentare ![]() , o diminuire
, o diminuire ![]() . Si può effettuare una scelta dei nuovi spessori che sia
compatibile con lo scaling solo se gli spessori attuali sono tali che
. Si può effettuare una scelta dei nuovi spessori che sia
compatibile con lo scaling solo se gli spessori attuali sono tali che ![]() è maggiore di
è maggiore di ![]() .
.
Se il gap deve rimanere invariato, qualunque sia la
relazione tra ![]() e
e ![]() ogni scelta dei nuovi
spessori è compatibile con lo scling.>
ogni scelta dei nuovi
spessori è compatibile con lo scling.>
![]()
if ![]() goto::ENDfail
goto::ENDfail
else (![]()
goto::1.);
<Dovendo aumentare il gap compatibilmente
con lo scaling, si diminuisce lo spessore attuale del film di Al (![]() ): dal momento che, per la d.,
): dal momento che, per la d., ![]() è una funzione
monotona crescente di
è una funzione
monotona crescente di ![]() , essa diminuisce.
, essa diminuisce.
Se il nuovo spessore è però minore di quello
minimo per cui il film sia continuo ![]() , si deve scegliere di aumentare
, si deve scegliere di aumentare ![]() , e quindi
, e quindi ![]() : ciò non porta alcun miglioramento in termini di scaling, o
peggiora la situazione (se il nuovo
: ciò non porta alcun miglioramento in termini di scaling, o
peggiora la situazione (se il nuovo ![]() è maggiore di
è maggiore di ![]() ).>
).>
![]()
if ![]() goto::ENDfail
goto::ENDfail
else (![]()
goto::1.);
<Dovendo diminuire il gap compatibilmente
con lo scaling, si diminuisce la profondità attuale dello scavo (![]() ): dal momento che, per la d.,
): dal momento che, per la d., ![]() è una funzione
monotona crescente di
è una funzione
monotona crescente di ![]() , essa diminuisce.
, essa diminuisce.
Se la nuova profondità è però minore di quello
minimo per cui lo scavo mantenga le sue caratteristiche ![]() , si deve scegliere di aumentare
, si deve scegliere di aumentare ![]() , e quindi
, e quindi ![]() : ciò non porta alcun miglioramento in termini di scaling, o
peggiora la situazione (se il nuovo
: ciò non porta alcun miglioramento in termini di scaling, o
peggiora la situazione (se il nuovo ![]() è maggiore di
è maggiore di ![]() ).>
).>
![]() ;
;
![]() ;
;
if (![]() or
or ![]() ) goto::ENDfail
) goto::ENDfail
else (![]() ;
;
![]()
goto::1.);
< Dovendo lasciare
invariato il gap compatibilmente con lo scaling, si diminuiscono ![]() e
e ![]() della stessa quantità:
per la e., il gap rimane quindi costante.>
della stessa quantità:
per la e., il gap rimane quindi costante.>
Per procedere nelle iterazioni della
procedura presentata è essenziale conoscere le disuguaglianze che legano ![]()
![]() , e lo spessore dei resist impiegati: i
dati raccolti in questo lavoro di tesi hanno permesso di stimarle per vari
valori di
, e lo spessore dei resist impiegati: i
dati raccolti in questo lavoro di tesi hanno permesso di stimarle per vari
valori di ![]() e
e ![]() .
.
Il primo processo portato a termine per intero (campione 489) prevedeva un passo di litografia con PUHR per definire il film di Al: il lift-off dello strato di 23nm di Al ha avuto successo ovunque, tranne che in prossimità dello scavo di 60nm.
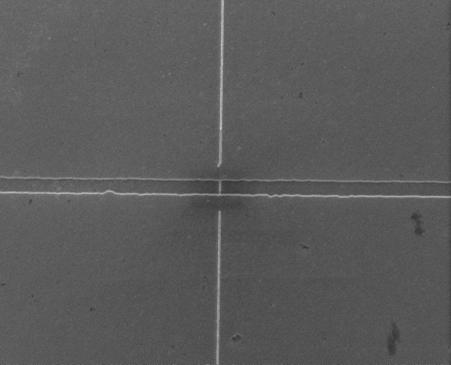
Fig. 2: Fallimento del lift-off del campione 489.
Per tali valori dello spessore di Al e della profondità dello scavo, si è quindi ottenuto:

La modifica al processo è stata naturalmente sostituire il PHR con il PUHR.
Il primo dispositivo realizzato con successo (campione 520) presenta i seguenti spessori:

Per diminuire il
valore del gap, dal momento che ![]() , si è diminuita la profondità dello scavo nel Si (istruzione
4.): il secondo dispositivo realizzato (campione 534) è quindi tale che:
, si è diminuita la profondità dello scavo nel Si (istruzione
4.): il secondo dispositivo realizzato (campione 534) è quindi tale che:

Si può ragionevolmente supporre che, essendo la spessore del bilayer 1.5% paria circa 80nm, per tale valore della profondità dello scavo valga:
![]()
Supponendo poi che
sia ancora: ![]() , il passo successivo sarebbe quindi quello di diminuire
ulteriormente lo spessore dello scavo, per ridurre
, il passo successivo sarebbe quindi quello di diminuire
ulteriormente lo spessore dello scavo, per ridurre ![]() , e reintrodurre il PUHR per il passo di evaporazione del
film di Al, il che ne dimezzerebbe la larghezza: la pista di Fig. 2 è infatti
larga 50nm.
, e reintrodurre il PUHR per il passo di evaporazione del
film di Al, il che ne dimezzerebbe la larghezza: la pista di Fig. 2 è infatti
larga 50nm.
 |
| Appunti su: |
|
| Appunti Biologia |  |
| Tesine Geografia |  |
| Lezioni Ingegneria tecnico |  |